欢迎参与评论,每一条合规评论都是对我们的褒奖。
请 登录 或 快速注册 后发表评论
在Semicon Taiwan 2024峰会期间,台积电(TSMC)介绍了使用3DIC技术集成AI芯片的重要性,里面包括了存储和逻辑芯片。台积电预计到2030年,全球半导体产业将达到1万亿美元,其中人工智能(AI)和高性能计算(HPC)占据了40%的市场份额,使得AI芯片成为了3D IC封装的关键驱动力。
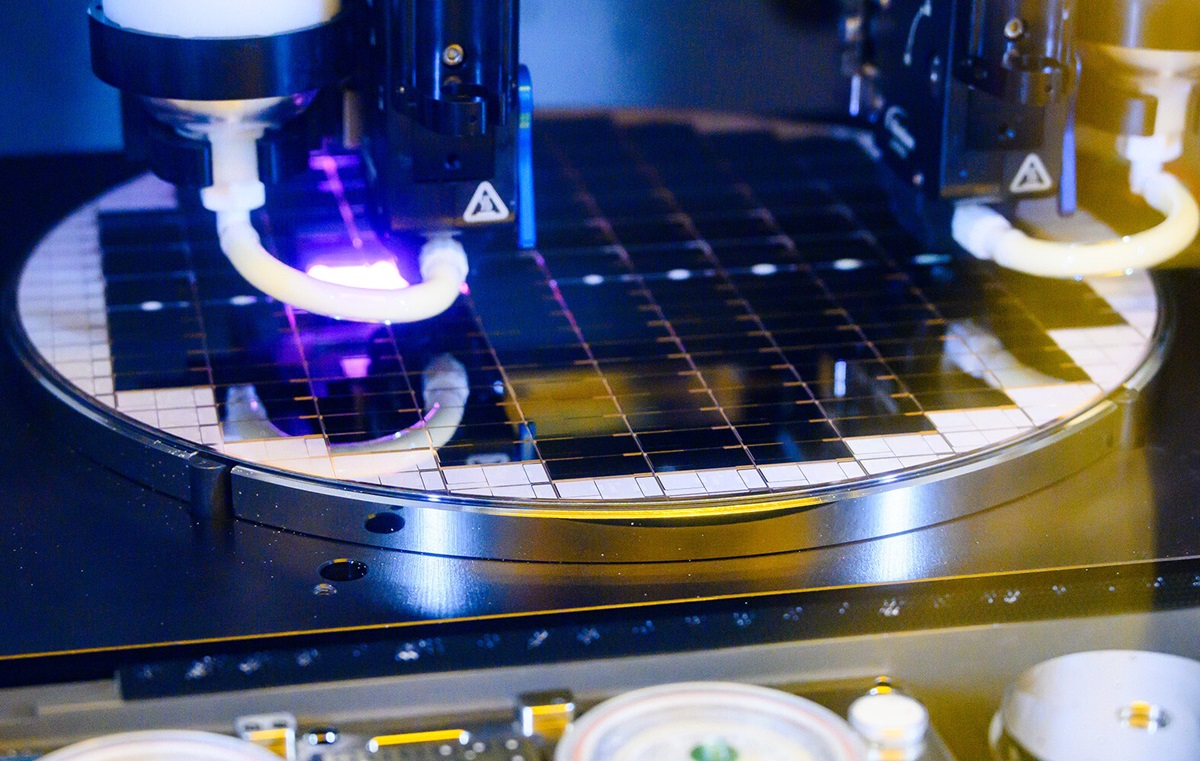
据TrendForce报道,台积电计划将传统的SoC+HBM设计转换为chiplet和HBM架构,新的逻辑芯片将是唯一需要从头设计的组件,而其他组件(比如I/O和SoC)可以使用现有的工艺技术。这种方法可将批量生产成本降低24%,尽管新架构可能会使生产成本增加2%,但总成本仍然可以降低22%。
到2027年,台积电可以为AI芯片提供3DIC集成的设计,其中包括了A16工艺制造的模块,另外可以搭配12个HBM4芯片。随着芯片尺寸的增加以及添加更多模块,虽然性能得到了提升,但也使得制造过程变得更加复杂,并伴随着更多的对齐错误、破损和提取失败的风险,如何提高3DIC技术的生产能力成为了关键。
为此台积电使用了自动化和标准化的工具、过程控制和质量仪器,以及3DFabric制造平台,以应对这些挑战。3DFabric是一种独特的、完全整合的解决方案,通过优化供应链中1500种不同材料类型的使用,加上与64家供应商的合作,提供了有力的保障。