欢迎参与评论,每一条合规评论都是对我们的褒奖。
请 登录 或 快速注册 后发表评论
近期台积电(TSMC)董事长兼首席执行官魏哲家介绍了“晶圆代工2.0”概念,重新定义了代工行业,将涵盖封装、测试和掩模制造等领域。随着人工智能(AI)等新应用需求激增,先进封装成为了一个热门的话题。此前有报道称,台积电已组建专门的团队,切入专业封装测试厂(OSAT)过去多年来一直开发的OPLP(Fan-out Panel Level Package,FOPLP)封装技术。
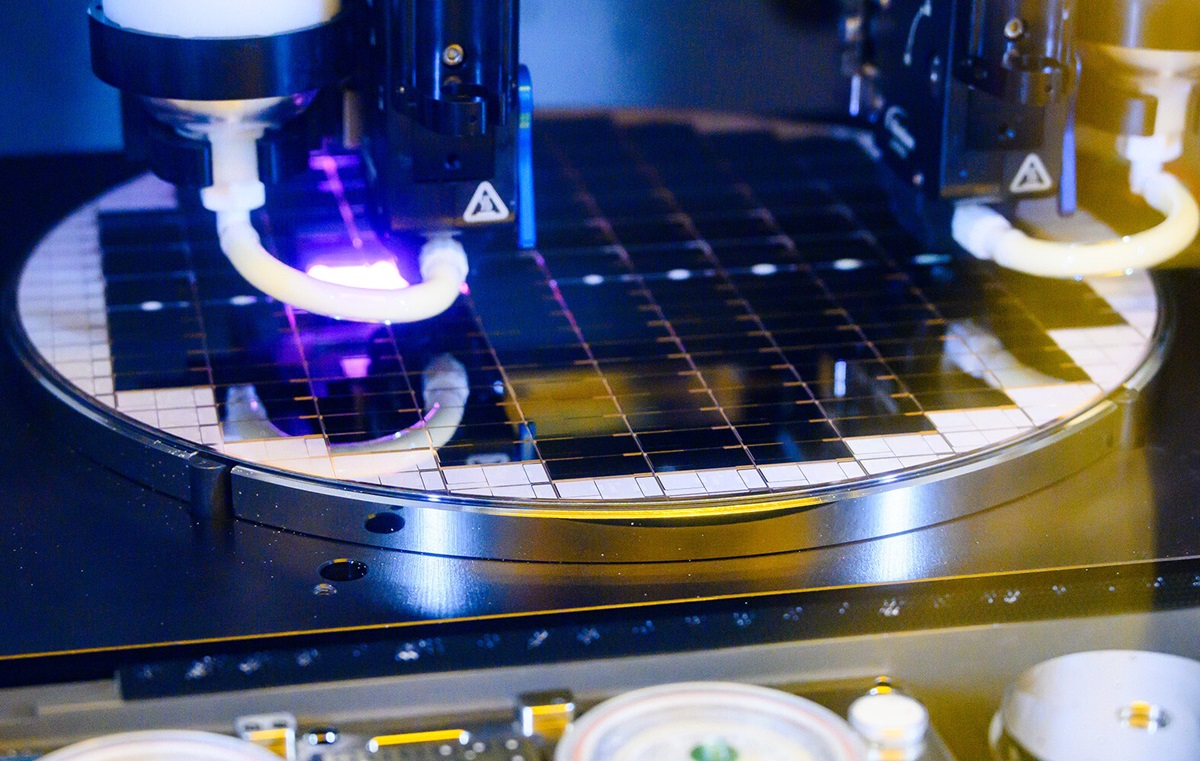
有报告称,台积电的CoWoS封装需求到2025年将一直保持高位,产能有可能连续两年翻一番。据TrendForce报道,台积电在先进封装领域强势地位引发了市场的担忧,加上种种迹象表明,未来台积电会将更多的资源投向尖端的后端技术,进一步巩固市场地位,专业封装测试厂的机会可能会越来越少。
随着先进制程节点的开发越来越困难,先进封装成为了性能提升的关键,不但有助于增强性能、降低成本,而且还能用于绑定顶级客户高端产品,提升竞争优势。此外,与前端技术相比,后端技术所需的投资要小得多,使其成为了新一轮半导体竞赛中的关键领域。目前台积电保留了大部分主要的CoWoS封装订单,并与部分专业封装测试厂合作,外包部分订单。
台积电开发中的FOPLP可以看作是矩形CoWoS封装,目前主要针对以英伟达为主的AI GPU领域,具有单位成本更低、封装尺寸更大的等优势。未来还可以进一步整合台积电3D Fabric平台上的其他技术,为2.5D/3D先进封装解决方案服务于高端产品应用铺平道路。